Vacuum System Fundamentals for Semiconductor Processing Equipment
By NineScrolls Engineering · 2026-03-28 · 14 min read · Materials Science
Target Readers: Process engineers, equipment engineers, facilities engineers, lab managers, and technical procurement teams working with vacuum-based semiconductor processing equipment (etchers, CVD systems, ALD, PVD). Newcomers will benefit from the fundamentals and comparison tables; experienced engineers can skip to the leak detection, conductance calculations, and maintenance sections.
TL;DR Summary
Every plasma etcher, CVD reactor, and deposition system relies on a well-designed vacuum system to control process gas purity, enable plasma ignition, and prevent contamination. This guide covers the three vacuum regimes relevant to semiconductor processing (rough, high, and ultra-high vacuum), the pump technologies used to reach each regime, pressure measurement techniques, gas flow physics, conductance and pumping speed calculations, leak detection methodology, outgassing management, load-lock design rationale, vacuum-compatible materials, and preventive maintenance schedules. Understanding these fundamentals helps engineers specify equipment, diagnose process drift, and maintain the base pressures that ensure repeatable thin-film and etch results.
1) Why Vacuum Matters in Semiconductor Processing
Semiconductor fabrication processes — reactive ion etching, plasma-enhanced CVD, atomic layer deposition, physical vapor deposition — all operate under sub-atmospheric pressures. Vacuum serves several critical functions:
- Mean free path control: At lower pressures, gas molecules travel further between collisions, enabling directional ion bombardment in etch processes and line-of-sight deposition in PVD
- Contamination reduction: Reducing background gas concentration (O₂, H₂O, hydrocarbons) prevents unwanted reactions with process gases and film incorporation of impurities
- Plasma ignition and stability: Plasma processes require specific pressure ranges (typically 1–100 mTorr for RIE/ICP) to sustain stable glow discharges
- Process repeatability: Consistent base pressure ensures that the ratio of process gas to residual gas remains controlled from run to run
- Film quality: Lower base pressures correlate with fewer defects, higher film density, and better electrical properties in deposited films
A process chamber that cannot reach or maintain its target base pressure will exhibit etch rate drift, poor film adhesion, particle generation, and ultimately device yield loss. For this reason, vacuum system design, operation, and maintenance are foundational skills for any semiconductor equipment engineer.
2) Vacuum Regimes and Their Applications
Vacuum is conventionally divided into regimes based on pressure range. Each regime has distinct gas dynamics, requires different pump technologies, and serves different semiconductor processes:

Figure 1: Vacuum regime chart — pressure ranges from atmosphere to UHV mapped against pump technology operating ranges, showing the complementary coverage of roughing pumps, turbomolecular pumps, cryopumps, and ion pumps
| Regime | Pressure Range | Mean Free Path | Typical Applications | Primary Pumps |
|---|---|---|---|---|
| Rough (Low) Vacuum | 760–10⁻¹ Torr | < 1 mm | Load-lock pump-down, PECVD (some), rough pumping stage | Rotary vane, scroll, roots blower |
| High Vacuum (HV) | 10⁻³–10⁻⁸ Torr | ~10 cm – 10 km | RIE, ICP-RIE, PECVD, sputtering, e-beam evaporation, ALD | Turbomolecular + dry/rotary backing pump |
| Ultra-High Vacuum (UHV) | < 10⁻⁸ Torr | > 10 km | MBE, surface analysis (XPS, AES), some advanced ALD | Ion pump, Ti sublimation pump, cryopump |
2.1 Rough Vacuum (760–0.1 Torr)
Rough vacuum represents the initial pump-down stage and the operating regime for some higher-pressure deposition processes. In this range, gas behavior is dominated by molecule-molecule collisions (viscous flow), and pumps work by mechanically compressing and displacing gas volumes. Most semiconductor process chambers transit through this regime during pump-down but do not operate here, with the exception of some atmospheric-pressure and low-vacuum PECVD configurations.
2.2 High Vacuum (10⁻³–10⁻⁸ Torr)
High vacuum is the workhorse regime for semiconductor processing. At these pressures, the mean free path of gas molecules exceeds the chamber dimensions, meaning molecular flow dominates. This is essential for:
- Controlled ion bombardment in RIE and ICP-RIE (typical operating pressure: 1–100 mTorr)
- Uniform precursor distribution in PECVD (100 mTorr–2 Torr)
- Self-limiting surface reactions in ALD (0.1–1 Torr during pulse, base pressure 10⁻⁶ Torr)
- Line-of-sight deposition in sputtering (1–10 mTorr)
The base pressure of the chamber before process gas introduction determines the "purity" of the process environment. A rule of thumb: the base pressure should be at least 100× lower than the operating pressure to ensure that residual gases constitute less than 1% of the process atmosphere.
2.3 Ultra-High Vacuum (< 10⁻⁸ Torr)
UHV is required when even trace contaminants are unacceptable — primarily in molecular beam epitaxy (MBE) and surface science instruments. Achieving UHV requires all-metal seals, bakeout procedures (150–250°C for 24–48 hours), electropolished stainless steel chambers, and specialized pumps (ion pumps, titanium sublimation pumps). While most production semiconductor equipment operates in the HV regime, some advanced ALD and atomic layer etching (ALE) processes are pushing toward lower base pressures to improve interface quality.
3) Pump Technologies
No single pump technology can efficiently operate from atmospheric pressure to UHV. Vacuum systems therefore use staged pump configurations, with rough pumps handling the initial pump-down and high-vacuum pumps taking over once the crossover pressure is reached.
3.1 Mechanical (Rough) Pumps
| Pump Type | Ultimate Pressure | Pumping Speed | Advantages | Limitations | Semiconductor Use |
|---|---|---|---|---|---|
| Rotary Vane | ~10⁻³ Torr | 5–60 m³/h | Low cost, reliable, high throughput at rough vacuum | Oil backstreaming, maintenance-intensive, vibration | Backing pump for turbo systems (legacy); being phased out in cleanrooms |
| Scroll | ~10⁻² Torr | 5–50 m³/h | Oil-free, low vibration, quiet | Lower pumping speed, tip seal wear, limited corrosive gas tolerance | Preferred backing pump in modern cleanroom equipment |
| Dry Screw | ~10⁻² Torr | 100–2500 m³/h | Oil-free, high pumping speed, corrosive gas compatible | Higher cost, larger footprint | Primary rough pump for production etch and CVD tools |
| Roots Blower | ~10⁻¹ Torr (with backing) | 250–10,000 m³/h | Very high volumetric throughput | Cannot operate standalone, requires backing pump | Booster for fast load-lock pump-down and high gas-flow processes |
Oil-free vs. oil-sealed: Modern semiconductor fabs overwhelmingly prefer oil-free (dry) pumps to eliminate hydrocarbon backstreaming, which can contaminate chamber surfaces and degrade film quality. Scroll pumps are the standard backing pump for research-scale systems, while dry screw pumps dominate production environments.
3.2 High-Vacuum Pumps
| Pump Type | Ultimate Pressure | Pumping Speed (N₂) | Operating Principle | Best For |
|---|---|---|---|---|
| Turbomolecular | ~10⁻¹⁰ Torr | 50–5,000 L/s | High-speed rotating blades impart momentum to gas molecules | RIE, ICP-RIE, sputtering, e-beam — most common HV pump in semiconductor equipment |
| Cryopump | ~10⁻¹⁰ Torr | 500–10,000 L/s | Cold surfaces (10–20 K) condense and trap gas molecules | High-throughput sputtering, MBE, load-locks needing fast pump-down |
| Ion Pump | < 10⁻¹¹ Torr | 1–500 L/s | Ionized gas molecules are accelerated into and buried in titanium cathode | UHV surface analysis, MBE, storage chambers — vibration-free, no moving parts |
| Ti Sublimation | < 10⁻¹¹ Torr | 1,000–10,000 L/s (getter) | Freshly deposited Ti film chemically getters reactive gases | Supplement to ion pumps in UHV systems |
Turbomolecular pumps are by far the most common high-vacuum pump in semiconductor processing equipment. They offer clean (no cryogen, no capture limitation), controllable pumping across all gas species, and can be throttled via gate valve or frequency control to regulate chamber pressure during processing. A typical RIE or ICP-RIE system uses a turbomolecular pump backed by a dry scroll or screw pump.
Cryopumps excel at water vapor pumping (very high H₂O pumping speed) and provide fast initial pump-down, making them ideal for load-locks and sputtering chambers. However, they require periodic regeneration (warming up to release accumulated gas) and have finite gas capacity — an important consideration for high-gas-flow etch processes.
3.3 Pump Selection Criteria for Semiconductor Equipment
When specifying or evaluating a vacuum pump for semiconductor process equipment, consider:
- Process gas compatibility: Corrosive gases (Cl₂, BCl₃, HBr) require corrosion-resistant pump materials. Turbopumps with treated rotor/stator and corrosion-resistant bearings are available for etch applications
- Pumping speed at operating pressure: Ensure the pump maintains adequate speed at the actual process pressure, not just at its rated optimal pressure
- Particle generation: Turbo pumps with magnetic bearings are preferred over grease/oil-lubricated bearings to eliminate particle sources
- Vibration sensitivity: For applications requiring sub-nm alignment (e.g., lithography-adjacent tools), magnetic-bearing turbo pumps or vibration-isolated configurations are essential
- Throughput requirements: High-gas-flow processes (DRIE at 100+ sccm SF₆) need high foreline pumping speed to prevent turbo pump overload
4) Pressure Measurement
Accurate pressure measurement is essential for process control, leak detection, and equipment qualification. No single gauge covers the full vacuum range, so semiconductor equipment typically employs multiple gauge types:
| Gauge Type | Measurement Range | Principle | Gas Dependent? | Typical Use in Semiconductor Equipment |
|---|---|---|---|---|
| Capacitance Manometer (CDG) | 10⁻⁴–1,000 Torr | Diaphragm deflection measured by capacitance change | No (absolute) | Process pressure control in etch and CVD — the gold standard for accuracy |
| Pirani Gauge | 10⁻³–760 Torr | Thermal conductivity of gas cools heated wire | Yes | Rough vacuum monitoring, foreline pressure, pump-down interlocks |
| Cold Cathode (Penning) | 10⁻² –10⁻⁹ Torr | Ionization current in crossed electric and magnetic fields | Yes | Chamber base pressure monitoring — rugged, no filament to burn out |
| Hot Cathode Ion Gauge (Bayard-Alpert) | 10⁻⁴–10⁻¹¹ Torr | Electron emission from hot filament ionizes gas; ion current measured | Yes | UHV base pressure measurement, leak checking qualification |
| Convection-Enhanced Pirani | 10⁻³–1,000 Torr | Combined thermal conductivity + convection | Yes | Wide-range rough vacuum, load-lock monitoring |
Key insight for process engineers: Capacitance manometers (CDGs) are the only gas-independent gauges in common semiconductor use. Since etch and CVD processes use varying gas mixtures, CDGs provide the most accurate process pressure readings. Thermal and ionization gauges are calibrated for N₂ or air and require correction factors for other gases — a common source of error when comparing readings across gauge types.
Combination gauges: Modern vacuum controllers often combine Pirani + cold cathode (or Pirani + ion gauge) into a single package covering 10⁻⁹ to 1,000 Torr, simplifying installation and providing full-range monitoring with automatic crossover between sensing elements.
5) Gas Flow Regimes
Understanding gas flow regimes is essential for designing vacuum plumbing, predicting pump-down times, and optimizing gas distribution in process chambers. The flow regime depends on the Knudsen number (Kn), the ratio of molecular mean free path (λ) to the characteristic dimension of the flow channel (D):

Figure 2: Three gas flow regimes — viscous flow (molecules interact with each other, Kn < 0.01), transition flow (mixed behavior), and molecular flow (molecules interact only with walls, Kn > 1), determined by the ratio of mean free path to system dimensions
| Flow Regime | Knudsen Number | Pressure Range (1" tube) | Behavior | Practical Significance |
|---|---|---|---|---|
| Viscous (Continuum) | Kn < 0.01 | > 0.5 Torr | Molecule-molecule collisions dominate; gas behaves as a fluid | Pump-down from atmosphere, foreline flow, gas delivery manifold |
| Transitional | 0.01 < Kn < 1 | 5 mTorr – 0.5 Torr | Both molecule-molecule and molecule-wall collisions significant | Many etch and CVD operating pressures; flow calculations require combined models |
| Molecular | Kn > 1 | < 5 mTorr | Molecule-wall collisions dominate; each molecule moves independently | Chamber base pressure, turbo pump operation, gas transport in high-vacuum regions |
Why this matters for equipment engineers: In the viscous regime, conductance (the ease with which gas flows through a tube or orifice) depends on pressure and scales with D⁴/L (Poiseuille flow). In the molecular regime, conductance is independent of pressure and scales with D³/L. This difference has major implications for foreline and chamber port sizing.
6) Conductance and Effective Pumping Speed
The effective pumping speed at the chamber (Seff) is always less than the rated pump speed (Spump) because of flow restrictions in the connecting tubing, gate valve, and foreline. The relationship follows the "resistors in series" analogy:
1/Seff = 1/Spump + 1/Ctotal
where Ctotal is the total conductance of the connecting path. For elements in series:
1/Ctotal = 1/C₁ + 1/C₂ + 1/C₃ + ...
Molecular Flow Conductance Formulas
For air at 20°C in the molecular flow regime:
- Circular tube: C = 12.1 × D³/L (L/s), where D and L are in cm
- Circular aperture: C = 11.6 × A (L/s), where A is the area in cm²
- Rectangular duct: C ≈ 9.7 × (a²b²)/(a+b)/L (L/s), where a and b are cross-section dimensions in cm
Practical example: A turbomolecular pump rated at 300 L/s is connected to a chamber through a 10 cm diameter, 30 cm long tube and a gate valve (equivalent to a 10 cm aperture). The tube conductance is 12.1 × 10³/30 = 403 L/s. The aperture conductance is 11.6 × π × 5² = 912 L/s. Total conductance: 1/C = 1/403 + 1/912 → C = 280 L/s. Effective pumping speed: 1/Seff = 1/300 + 1/280 → Seff = 145 L/s — less than half the rated pump speed.
This example illustrates why chamber port and foreline design are as important as pump selection. Short, wide-diameter connections maximize conductance and preserve pumping speed at the chamber.
7) Leak Detection
Leaks are the most common cause of poor base pressure, process contamination, and run-to-run variation in semiconductor equipment. A systematic approach to leak detection is essential for both initial qualification and ongoing maintenance.
7.1 Types of Leaks
- Real leaks: Physical paths through chamber walls, O-ring seals, weld defects, feedthrough connections, or cracked viewports. These admit atmospheric gas (N₂, O₂, H₂O, Ar) into the vacuum volume
- Virtual leaks: Trapped gas volumes that slowly outgas into the chamber — e.g., blind tapped holes, double O-ring gaps without pump-out ports, or porous welds. Virtual leaks mimic real leaks but cannot be found with external tracer gas methods
- Permeation: Gas molecules diffusing through solid materials (especially elastomer seals). Permeation is temperature-dependent and sets the ultimate pressure floor for elastomer-sealed systems
7.2 Helium Leak Testing
Helium mass spectrometer leak detection (MSLD) is the gold standard for semiconductor vacuum systems. Helium is used because:
- It is a small molecule (high diffusivity through small leak paths)
- Its atmospheric concentration is only ~5 ppm (low background)
- It is inert (safe, non-contaminating)
- Mass 4 is easily distinguished from other residual gas peaks
Procedure: The leak detector is connected to the vacuum system (either directly or through the turbo pump exhaust). Helium is sprayed systematically around suspected leak sites (fittings, O-ring grooves, weld seams, feedthroughs) using a fine probe. A rising helium signal on the detector indicates a leak at the sprayed location. Typical acceptance criteria for semiconductor process chambers:
- Production etch/CVD tools: Total leak rate < 1 × 10⁻⁹ Torr·L/s
- Research systems: Total leak rate < 5 × 10⁻⁹ Torr·L/s
- UHV systems: Total leak rate < 1 × 10⁻¹⁰ Torr·L/s
7.3 Rate-of-Rise Test
The rate-of-rise (RoR) test provides a quick assessment of overall system integrity without a He leak detector. The procedure is straightforward:
- Pump the chamber to base pressure
- Close the gate valve (isolate the chamber from the pump)
- Monitor pressure rise over 5–30 minutes
- Calculate the leak + outgassing rate: Q = V × (ΔP/Δt), where V is chamber volume
The limitation of rate-of-rise testing is that it cannot distinguish between real leaks and outgassing. A new chamber or one recently opened to atmosphere will show high initial outgassing that decreases over time. By comparing the rate-of-rise curve shape (exponentially decaying = outgassing dominant; linear = real leak dominant), an experienced engineer can differentiate the two contributions.
8) Chamber Outgassing
Outgassing — the desorption of gas molecules from chamber walls and internal components — is the primary limiting factor for achieving low base pressures after the system has been pumped below ~10⁻⁵ Torr. At this point, the gas load is dominated by water vapor and hydrocarbons desorbing from surfaces, not bulk gas in the chamber volume.
Sources of Outgassing
- Water vapor: Adsorbed H₂O is the dominant outgassing species. A freshly vented aluminum chamber at atmospheric humidity releases ~10⁻⁸ Torr·L/s/cm² initially, decreasing roughly as 1/t
- Hydrocarbons: Fingerprints, machining oils, and O-ring lubricants contribute organic outgassing
- Dissolved gases: H₂ diffusing from stainless steel walls (important for UHV systems)
- Process residues: Polymer deposits from previous etch/CVD runs release gases during pump-down
Outgassing Mitigation Strategies
- Bakeout: Heating the chamber to 100–200°C accelerates desorption of surface-adsorbed water and organics. A 24-hour bake at 150°C typically reduces H₂O outgassing by 10–100×
- Dry venting: Venting chambers with dry N₂ (or clean dry air) instead of ambient air dramatically reduces re-adsorbed water. Some tools include automated N₂ purge-vent sequences
- Surface treatment: Electropolishing reduces surface area and removes embedded contaminants from stainless steel. Anodization protects aluminum from oxidation and reduces its outgassing rate
- Minimize polymer/elastomer surface area: Use metal seals where feasible; choose low-outgassing elastomers (Viton, Kalrez) for O-rings
- Chamber seasoning: Running a brief conditioning plasma (e.g., O₂ or Ar plasma) after pump-down helps remove adsorbed contaminants from internal surfaces
9) Load-Lock Design
Load-locks are small-volume intermediate chambers that allow wafer transfer without venting the process chamber to atmosphere. Their inclusion is one of the most impactful design decisions in semiconductor processing equipment.
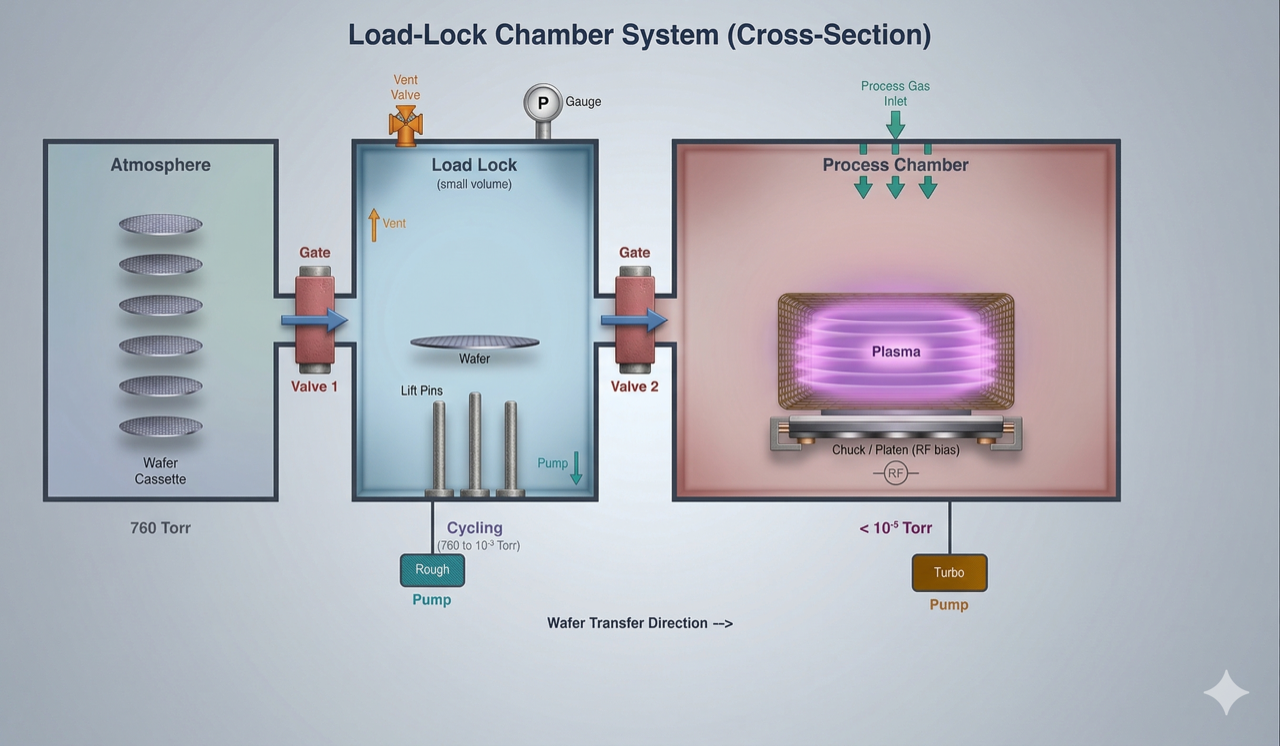
Figure 3: Load-lock system schematic — a small-volume intermediate chamber cycles between atmosphere and vacuum, protecting the process chamber from contamination while enabling efficient wafer transfer
Why Load-Locks Matter
- Throughput: Pumping a 50 L load-lock from atmosphere to 10⁻⁵ Torr takes 1–3 minutes. Pumping a 200 L process chamber from atmosphere takes 30–60+ minutes (including outgassing). Without a load-lock, every wafer exchange incurs this penalty
- Base pressure maintenance: Each atmospheric exposure introduces ~10¹⁹ H₂O molecules per cm² of chamber surface. A load-lock prevents this contamination of the process chamber
- Process repeatability: Process chambers that are never vented maintain consistent surface conditioning and base pressure, resulting in tighter run-to-run variation
- Particle control: The load-lock acts as a buffer zone, preventing ambient particles from reaching the process chamber
Load-Lock Design Considerations
- Volume: Minimize volume for fastest pump-down — typically 2–10 L for single-wafer tools
- Pump selection: Turbo pump (for HV transfer pressure) or cryopump (for fast water pumping). Some designs use roughing pump only if the transfer pressure requirement is modest (10⁻¹–10⁻² Torr)
- Vent gas: Clean dry N₂ with particle filter. Flow rate controlled to prevent wafer displacement
- Isolation valves: Gate valve or slit valve between load-lock and process chamber, rated for process vacuum and compatible with process chemistry
- Wafer transfer mechanism: Fork, paddle, or robotic arm with clean, non-contaminating contact surfaces
10) Vacuum Materials
Material selection for vacuum systems requires balancing mechanical strength, chemical compatibility with process gases, outgassing rate, thermal properties, and cost.
10.1 Metals
| Material | Advantages | Limitations | Typical Application |
|---|---|---|---|
| 304/316 Stainless Steel | Strong, machinable, low outgassing when electropolished, weldable | Heavy, higher cost than Al, H₂ permeation at elevated temp | UHV chambers, gas lines, flanges, feedthroughs |
| 6061-T6 Aluminum | Lightweight, excellent thermal conductivity, easy to machine, anodizable | Softer, limited to ~200°C bake, corroded by some process gases (Cl₂, HBr) | Process chambers (with anodization), load-locks, chamber lids |
| Copper (OFHC) | Excellent thermal conductivity, low outgassing | Oxidizes easily, heavy, limited structural strength | Gaskets (ConFlat), RF electrodes, heat sinks |
| Inconel / Hastelloy | Exceptional corrosion resistance, high-temperature capability | Very expensive, difficult to machine | Gas delivery components in corrosive environments |
10.2 Elastomers (O-ring Materials)
| Material | Max Temp (°C) | Outgassing Rate | Chemical Resistance | Notes |
|---|---|---|---|---|
| Buna-N (NBR) | ~120 | High | Poor (halogen gases) | Not recommended for semiconductor vacuum; acceptable for rough vacuum only |
| Viton (FKM) | ~200 | Low | Good | Standard semiconductor O-ring material; good balance of cost and performance |
| Kalrez (FFKM) | ~315 | Very low | Excellent | Premium option for aggressive chemistries; 5–10× cost of Viton |
| Metal Seals (Cu, Al, Ni) | > 450 | Negligible | Excellent | Required for UHV; ConFlat flanges with OFHC copper gaskets |
10.3 Ceramics and Insulators
Ceramics serve as electrical insulators, plasma-facing components, and viewport windows in semiconductor vacuum equipment:
- Alumina (Al₂O₃): The most common ceramic in vacuum systems — used for electrical feedthroughs, RF windows, insulating spacers. Good vacuum compatibility, moderate thermal shock resistance
- Quartz (SiO₂): Used for chamber windows, tube furnaces, and some process chamber liners. Transparent to UV, excellent purity, but limited to moderate-temperature applications
- Boron nitride (BN): Machinable ceramic with excellent thermal shock resistance. Used as heater element supports and insulating spacers
- Sapphire: Scratch-resistant viewport material for aggressive plasma environments
11) Vacuum System Maintenance
Preventive maintenance of the vacuum system directly impacts base pressure, pump-down time, process repeatability, and equipment uptime. The following table summarizes typical maintenance intervals for semiconductor processing equipment:
| Component | Maintenance Task | Frequency | Indicators of Need |
|---|---|---|---|
| Rotary Vane Pump | Oil change, oil filter replacement | Every 3–6 months (or per manufacturer spec) | Discolored oil, elevated ultimate pressure, unusual noise |
| Scroll Pump | Tip seal replacement | Every 15,000–30,000 hours (varies by model) | Rising ultimate pressure, increased current draw |
| Turbomolecular Pump | Bearing replacement (grease type) or controller service (mag-lev) | Every 20,000–40,000 hours | Increased vibration, spin-up time, elevated base pressure |
| Cryopump | Regeneration (warm-up and pump-out of accumulated gas) | Every 500–10,000 hours (process-dependent) | Rising base pressure, reduced pumping speed, crossover pressure not achieved |
| O-rings | Inspect, clean, re-grease, replace | Every chamber opening (inspect); replace every 6–12 months or when damaged | Visible cracks, flat spots (compression set), elevated leak rate |
| Pressure Gauges | Calibration check, filament replacement (ion gauge) | Annual calibration; filament as needed | Readings inconsistent with other gauges, filament burnout |
| Gate Valve | Seal inspection, actuator service | Every 12 months or 50,000 cycles | Slow operation, leak across closed valve |
| Foreline Trap/Filter | Replace or clean filter element | Every 3–6 months (process-dependent) | Elevated foreline pressure, restricted flow |
Cryopump regeneration deserves special attention. During operation, cryopumps accumulate condensed process gases and water vapor on their cold arrays. When capacity is reached, pumping efficiency degrades. Regeneration involves warming the cryopump to room temperature, purging the released gas through a roughing pump, and then re-cooling. Full regeneration takes 2–4 hours. Partial (quick) regeneration — warming only the first-stage array — takes 30–60 minutes and is effective when water vapor is the primary accumulated species.
12) Relating Vacuum System Design to Equipment Selection
When evaluating semiconductor process equipment, the vacuum system design reveals a great deal about overall equipment quality and fitness for purpose. Key questions to ask:
- Base pressure specification: What base pressure does the system achieve, and how long does it take to reach it? A well-designed system should reach 10⁻⁶ Torr within 30–60 minutes of initial pump-down
- Pump configuration: Is the turbo pump directly mounted (short, high-conductance path) or remotely mounted (longer pipe, lower effective pumping speed)? Direct mounting is preferred
- Pressure control: Does the system use a throttle valve or conductance-based pressure control? Closed-loop throttle valve control with a capacitance manometer provides the tightest pressure regulation
- Load-lock: Is a load-lock included? For research systems, a load-lock dramatically improves base pressure recovery time and process consistency
- Leak integrity: What is the specified total leak rate? Does the manufacturer perform He leak testing during assembly?
- Materials: Are O-ring materials specified for the intended process chemistry? Are chamber surfaces treated (anodized, electropolished) to reduce outgassing and particle generation?
For related information on how vacuum conditions affect specific process technologies, see our guides on reactive ion etching, PECVD, and atomic layer deposition.
NineScrolls Semiconductor Processing Equipment
Our etch, deposition, and cleaning systems feature optimized vacuum designs with turbo-pumped process chambers, automated load-locks, capacitance manometer pressure control, and He leak-tested construction — ensuring the base pressures and process stability that demanding applications require.
Frequently Asked Questions
What base pressure should a process chamber achieve for reliable etch and CVD results?
As a general rule, the base pressure should be at least 100× lower than the process operating pressure. For typical RIE/ICP-RIE processes operating at 5–50 mTorr, a base pressure of 5 × 10⁻⁶ Torr or better is recommended. For PECVD operating at 0.5–2 Torr, a base pressure of 10⁻⁵ to 10⁻⁶ Torr is adequate. For ALD, where interface purity is critical, base pressures of 10⁻⁶ Torr or better ensure minimal background oxygen and moisture incorporation. If the system consistently fails to reach its specified base pressure within the expected pump-down time, this indicates a leak, excessive outgassing, or pump degradation — all of which should be investigated before running process wafers.
How do I determine whether a rising base pressure is caused by a real leak or outgassing?
Perform a rate-of-rise test by isolating the chamber from the pump and monitoring pressure vs. time. A real leak produces a linear (constant-slope) pressure rise because atmospheric gas flows in at a steady rate. Outgassing produces a decelerating curve — fast initially, then slowing as adsorbed species deplete. If you plot pressure vs. time and the slope is constant after several minutes, suspect a real leak and proceed with helium leak testing. If the rate decreases with time, the dominant contribution is outgassing, which can be reduced through extended pumping, bakeout, or chamber cleaning. A residual gas analyzer (RGA) can further clarify: a real air leak shows an N₂:O₂ ratio of approximately 4:1 (matching atmospheric composition), while outgassing typically shows dominant H₂O (mass 18) and hydrocarbon fragment peaks.
When should I choose a cryopump over a turbomolecular pump for a semiconductor process tool?
Cryopumps are preferred when extremely fast water vapor pump-down is critical (cryopumps have 2–5× higher H₂O pumping speed than turbo pumps of similar nominal size), when high pumping speeds are needed without the cost of very large turbo pumps, or when vibration must be minimized (cryopumps have no high-speed rotating parts). They are commonly chosen for sputtering systems, load-locks, and MBE chambers. However, turbo pumps are generally better for etch processes because: (1) cryopumps have finite gas capacity and require regeneration, which is impractical for high-gas-flow processes; (2) corrosive etch byproducts (SiF₄, chlorides) can damage cryopump surfaces; and (3) turbo pumps can be throttled for continuous pressure control during processing. For most RIE, ICP-RIE, PECVD, and ALD applications, a turbomolecular pump with a dry backing pump is the standard and recommended configuration.
Why are oil-free (dry) pumps strongly preferred over oil-sealed pumps in semiconductor processing?
Oil-sealed rotary vane pumps generate hydrocarbon vapor that can backstream into the vacuum chamber, depositing on chamber walls, wafer surfaces, and turbo pump rotors. Even with foreline traps, trace hydrocarbons reach the process chamber and can cause: (1) carbon contamination in deposited films, degrading electrical properties; (2) particle generation from polymerized oil residue, especially under plasma exposure; (3) reduced adhesion for subsequent film depositions; and (4) interference with surface-sensitive processes like ALD. Oil-free scroll and dry screw pumps eliminate these risks entirely. The marginal cost premium of dry pumps is easily justified by improved process yields, reduced chamber cleaning frequency, and the avoidance of oil mist in the cleanroom environment. For any new semiconductor equipment purchase, specifying oil-free roughing pumps should be a baseline requirement.
What is the purpose of a load-lock, and is it necessary for research-scale equipment?
A load-lock is a small intermediate chamber that allows wafer loading and unloading without venting the main process chamber to atmosphere. Its benefits include: (1) dramatically faster wafer exchange (1–3 minutes for load-lock pump-down vs. 30–60+ minutes for a full chamber pump-down); (2) consistent base pressure and chamber surface conditioning, since the process chamber is never exposed to atmospheric moisture; (3) better process repeatability from run to run; and (4) reduced particle contamination. For research systems, a load-lock is highly recommended but sometimes omitted to reduce equipment cost and complexity. Without a load-lock, each wafer exchange requires full chamber pump-down, and the first process run after venting typically shows different results than subsequent runs due to residual moisture. If budget permits, the productivity and data quality improvements from a load-lock more than justify its cost, even in a research setting.