Ion Beam Etching (IBE) & RIBE: Principles, Applications, and Equipment Guide
By NineScrolls Engineering · 2026-03-22 · 16 min read · Materials Science
Target Readers: Process engineers working with magnetic materials, noble metals, or complex thin-film stacks; PIs and lab managers evaluating physical etching solutions; R&D teams in spintronics, photonics, and MEMS who need damage-controlled, material-agnostic patterning; and procurement teams comparing IBE/RIBE platforms against RIE and ICP-RIE alternatives.
TL;DR
- Ion Beam Etching (IBE) uses a collimated, energetic beam of inert ions (typically Ar+) extracted from a dedicated ion source to physically sputter material from a substrate. Because the beam is generated remotely from the substrate, ion energy and flux are independently controlled — a key advantage over conventional RIE.
- Reactive Ion Beam Etching (RIBE) adds reactive gases (O&sub2;, CHF&sub3;, Cl&sub2;, etc.) to the ion source, combining physical sputtering with chemical volatilization for higher selectivity and reduced redeposition while retaining beam directionality.
- IBE/RIBE excels at etching materials that form non-volatile etch products — noble metals (Pt, Au, Ir), magnetic alloys (NiFe, CoFe, CoFeB), and piezoelectrics (PZT, LiNbO&sub3;) — where plasma-based RIE simply cannot produce gaseous byproducts.
- The tilting/rotating substrate stage (0–90°) enables angle-controlled etching for sidewall profile tuning and redeposition management, which is critical for sub-100 nm magnetic tunnel junction (MTJ) patterning.
- NineScrolls IBE/RIBE systems offer Kaufman-type sources (up to 6″ wafers) and RF ion sources (up to 12″ wafers), base pressure <7×10¹²&sup7; Torr, tilt 0–90°, rotation 1–10 rpm, and <5% film non-uniformity.
1. What is Ion Beam Etching?
Ion Beam Etching (IBE), also known as ion milling, is a physical dry-etching technique in which a broad, collimated beam of energetic ions is directed at a substrate to remove material by momentum-transfer sputtering. Unlike reactive ion etching (RIE), where the substrate sits immersed in a plasma, IBE generates ions in a separate ion source and accelerates them through extraction grids toward the target. This decoupled architecture provides several fundamental advantages:
- Independent control of ion energy and flux: Beam voltage sets the energy (typically 200–1200 eV), while source power and gas flow set the current density. In RIE, these parameters are coupled through RF power and pressure.
- No plasma exposure of the substrate: The substrate sees only the directed ion beam, eliminating radical-driven isotropic etching, UV-induced charge damage, and plasma non-uniformity effects.
- Angle-of-incidence control: A tilting, rotating stage allows the beam to strike the substrate at any angle from 0° (normal incidence) to 90° (grazing), enabling precise sidewall profile engineering and redeposition cleanup.
- Material universality: Because sputtering is purely physical, IBE can etch any solid material regardless of whether it forms volatile etch products — the defining limitation of RIE and ICP-RIE.
For a direct comparison of ion milling versus reactive approaches, see our article on Reactive Ion Etching vs Ion Milling.
2. Ion Source Physics: How the Beam is Generated
The ion source is the heart of any IBE system. Its role is to ionize a working gas (usually argon) and extract the resulting ions as a directed beam with controlled energy and current density. Two architectures dominate the market:
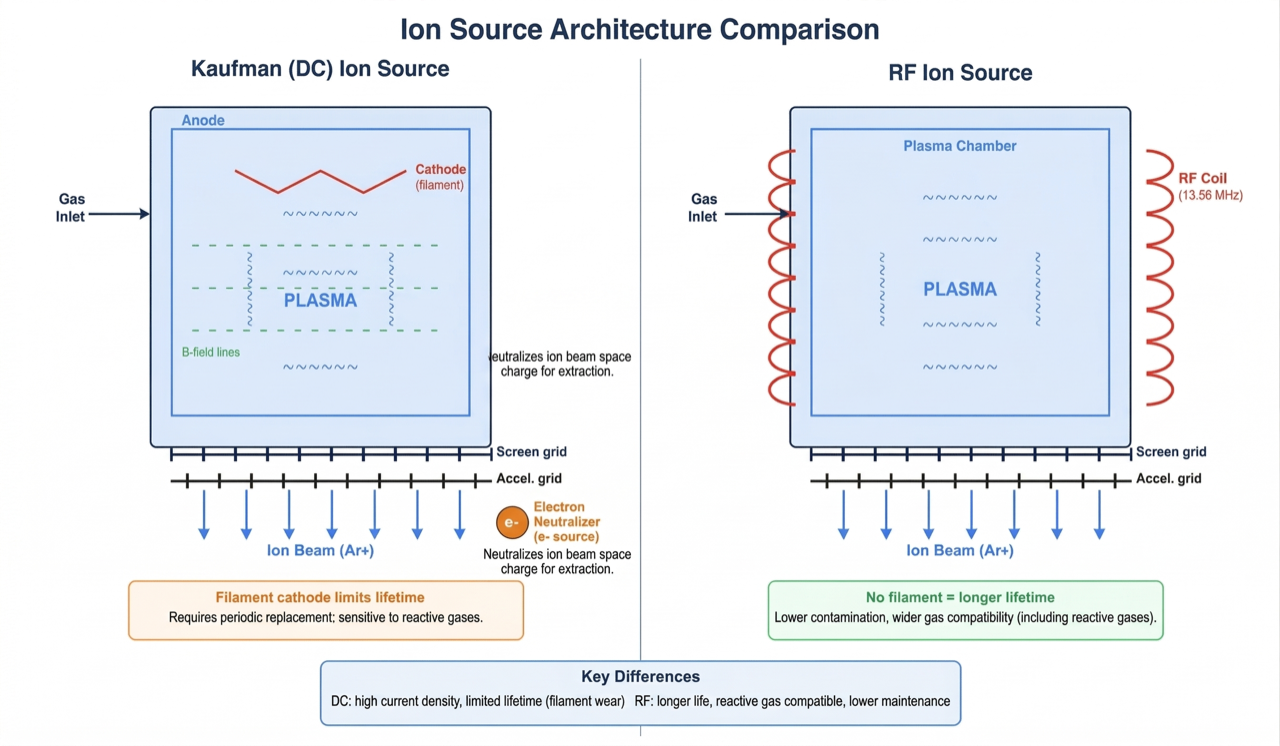
Figure 1: Kaufman (DC) vs RF ion source architectures — the Kaufman source uses a thermionic cathode filament and magnetic confinement, while the RF source eliminates consumable filaments by using inductive RF coupling for plasma generation
2.1 Kaufman-Type (DC Discharge) Ion Source
Invented by Harold Kaufman at NASA in the 1960s for spacecraft propulsion, the Kaufman source uses a thermionic cathode (typically a tungsten or LaB&sub6; filament) to emit electrons into a discharge chamber. These electrons are confined by an axial magnetic field, increasing their path length and ionization efficiency. The resulting plasma is then extracted through a set of multi-aperture grids:
- Screen grid: Held at high positive potential (beam voltage, 200–1500 V), defines the plasma boundary
- Accelerator grid: Held at negative potential (−100 to −300 V), extracts and focuses ions into beamlets
- Decelerator grid (optional): At ground or slightly positive potential, reduces downstream ion divergence
The extracted beamlets merge into a broad, roughly uniform beam. A downstream neutralizer filament or hollow-cathode emits electrons into the beam to prevent charge buildup on insulating substrates.
Advantages: Well-understood, reliable, excellent beam uniformity over small-to-medium areas, straightforward maintenance (filament replacement). Limitations: Filament lifetime (typically 50–200 hours depending on gas), limited scalability to large diameters, potential filament contamination for sensitive processes.
2.2 RF (Inductively Coupled) Ion Source
RF ion sources eliminate the thermionic filament entirely. Instead, an RF coil (typically 13.56 MHz) wrapped around a dielectric discharge chamber (quartz or alumina) inductively couples energy into the gas. The resulting high-density plasma is extracted through the same multi-grid optics as a Kaufman source.
Advantages: No consumable filament (dramatically longer maintenance intervals), compatible with reactive gases (O&sub2;, CHF&sub3;, Cl&sub2;) without filament degradation, scalable to large beam diameters (supporting 8″–12″ wafer processing), and no metallic contamination from the source. Limitations: Higher RF power supply cost, slightly more complex impedance matching, marginally higher beam divergence than optimized Kaufman sources.
Kaufman vs RF Ion Source Comparison
| Parameter | Kaufman Source | RF Ion Source |
|---|---|---|
| Ionization method | DC discharge with thermionic cathode | RF inductively coupled plasma |
| Filament | Required (W or LaB&sub6;); 50–200 hr lifetime | None (filament-free) |
| Reactive gas compatibility | Limited (filament degradation) | Excellent (no filament to attack) |
| Scalable beam diameter | Up to ~6″ | Up to ~12″ |
| Contamination risk | Low risk of filament metal (W) sputter | Negligible (dielectric chamber) |
| Beam uniformity | Excellent (<5% over beam area) | Good to excellent (<5% with optimization) |
| Maintenance | Filament replacement every 50–200 hrs | Grid inspection/replacement; longer intervals |
| Cost | Lower initial cost | Higher (RF supply + matching network) |
| Best suited for | R&D, small-wafer IBE, Ar-only milling | Production, RIBE, large wafers, reactive gases |
3. IBE vs RIBE: Operating Modes
An IBE/RIBE system can operate in several distinct modes depending on the gas feed configuration:
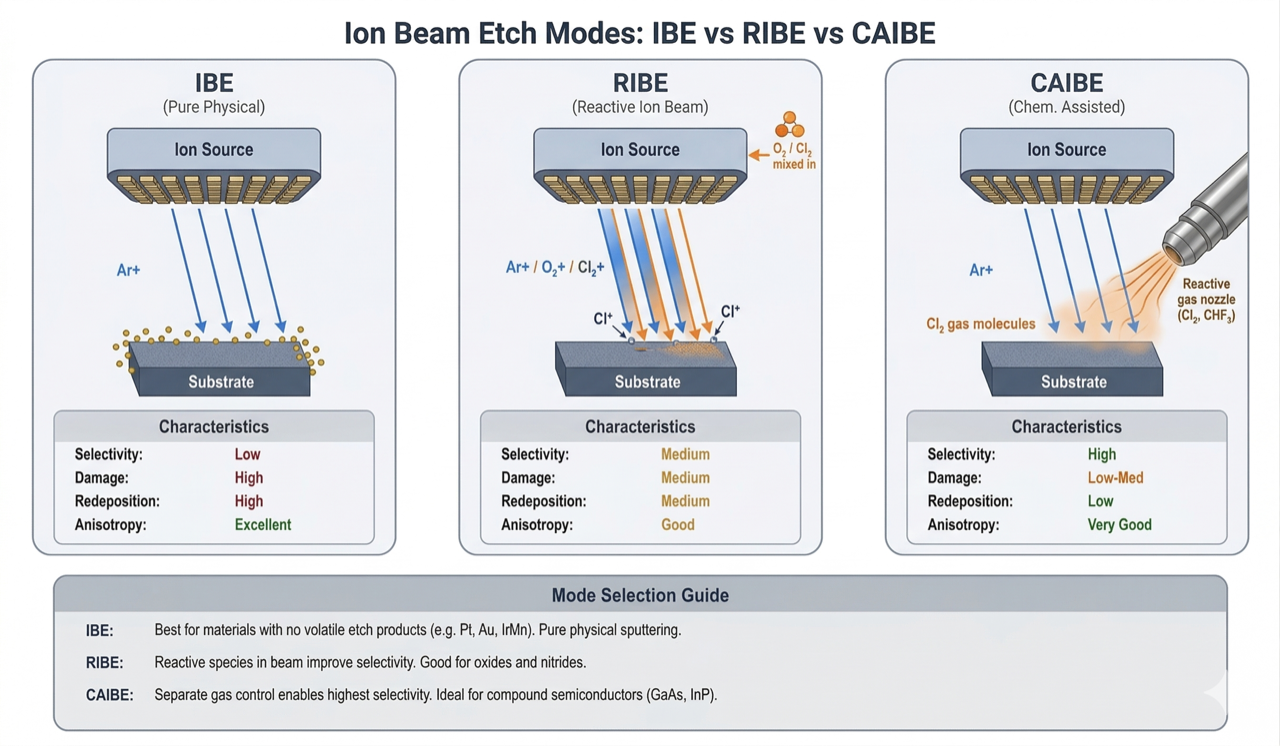
Figure 2: Three ion beam etch modes compared — IBE uses pure Ar⁺ physical sputtering, RIBE introduces reactive gas into the ion source, and CAIBE delivers reactive gas separately near the substrate surface
3.1 Pure IBE (Ion Milling)
Only inert gas (Ar, Xe, or Kr) is fed into the ion source. Material removal is entirely by physical sputtering. This is the mode of choice for materials with non-volatile etch products:
- Magnetic alloys: NiFe (Permalloy), CoFe, CoFeB, MnIr, PtMn — chlorine and fluorine chemistries do not produce volatile compounds with these elements
- Noble metals: Pt, Au, Ir, Ru — chemically inert by definition
- Complex oxides: PZT (PbZrTiO&sub3;), BaTiO&sub3;, LiNbO&sub3; — multi-component materials where selective chemical volatilization would cause stoichiometry loss
The tradeoff: pure sputtering offers no chemical selectivity, so mask erosion is faster and redeposition of sputtered material on sidewalls and chamber surfaces is significant. Careful angle optimization and stage rotation are essential. For metal-specific chemistries, mask choices, and post-etch corrosion control across the full process-metal portfolio, see the Metal Etching Complete Guide.
3.2 Reactive Ion Beam Etching (RIBE)
Reactive gas (O&sub2;, CHF&sub3;, CF&sub4;, Cl&sub2;, or mixtures) is introduced into the ion source itself, producing reactive ions (O¹+, CF&sub3;¹+, Cl¹+) in the beam. These ions both sputter and chemically react with the substrate, forming volatile products that are pumped away.
Benefits over pure IBE:
- Higher etch rates for materials that form volatile etch products (e.g., Si + F-containing beam → SiF&sub4;↑)
- Improved selectivity between different film layers
- Reduced redeposition since etch byproducts leave as gases rather than redepositing as solid films
- Lower ion energies possible since chemical assistance supplements physical sputtering, reducing substrate damage
3.3 Chemically Assisted Ion Beam Etching (CAIBE)
A closely related variant where the reactive gas is introduced at the substrate rather than through the ion source. The inert ion beam provides the activation energy while reactive gas molecules adsorbed on the surface provide the chemistry. CAIBE offers even more independent control of ion energy and chemical flux, though it adds complexity and is less commonly used than RIBE.
Operating Mode Summary
| Mode | Gas Feed | Mechanism | Selectivity | Redeposition | Best For |
|---|---|---|---|---|---|
| IBE | Ar into source | Physical sputtering | Poor (sputter-yield ratio only) | High | Magnetic metals, noble metals, complex oxides |
| RIBE | Reactive gas into source | Physical + chemical (reactive ions) | Moderate to good | Moderate | Dielectrics, semiconductors, mixed stacks |
| CAIBE | Ar into source, reactive gas at substrate | Physical + surface chemistry | Good | Low to moderate | III-V facet etching, precision endpoint |
4. IBE/RIBE vs RIE and ICP-RIE: When to Use What
Choosing between ion beam etching and plasma-based etching depends on the material, the required profile, damage tolerance, and throughput needs. Here is a practical comparison:
| Criterion | IBE/RIBE | RIE | ICP-RIE |
|---|---|---|---|
| Ion/plasma coupling | Fully decoupled (source separate from substrate) | Coupled (single RF) | Partially decoupled (ICP + bias RF) |
| Ion energy range | 200–1500 eV (grid-defined) | 50–500 eV (self-bias) | 10–500 eV (bias-controlled) |
| Angle control | Full 0–90° tilt + rotation | Normal incidence only | Normal incidence only |
| Non-volatile materials | Excellent (primary strength) | Very limited | Limited |
| Etch rate (Si, SiO&sub2;) | Low (10–50 nm/min typical) | Moderate (50–300 nm/min) | High (100–1000+ nm/min) |
| Selectivity | Low in IBE mode; moderate in RIBE | Moderate to high | High (chemistry-driven) |
| Plasma/charge damage | Minimal (neutralized beam) | Moderate | Low to moderate |
| Throughput | Lower (single-wafer, slower rates) | Moderate | High |
| Typical applications | MTJ/MRAM, magnetic sensors, noble metal electrodes, photonic devices, trimming | General Si/dielectric patterning | HAR Si etch, MEMS, III-V, advanced CMOS |
Rule of thumb: If your material forms volatile halides or fluorides, start with RIE or ICP-RIE. If it does not — or if you need precise angle control, minimal plasma damage, or multi-layer stack trimming — IBE/RIBE is the right tool.
5. Material Compatibility and Etch Rates
One of IBE’s greatest strengths is its near-universal material compatibility. Because sputtering depends on momentum transfer rather than chemical reactions, the key parameter is the sputter yield — atoms removed per incident ion — which varies with material, ion species, ion energy, and angle of incidence.
Representative Sputter Yields and Etch Rates (Ar+, 500 eV, normal incidence)
| Material | Category | Sputter Yield (atoms/ion) | Approx. Etch Rate (nm/min) |
|---|---|---|---|
| Au | Noble metal | 2.4–3.0 | 40–60 |
| Pt | Noble metal | 1.4–1.8 | 20–35 |
| Cu | Metal | 2.0–2.5 | 35–50 |
| NiFe (Permalloy) | Magnetic alloy | 1.5–2.0 | 25–40 |
| CoFeB | Magnetic alloy | 1.2–1.6 | 20–30 |
| SiO&sub2; | Dielectric | 0.8–1.2 | 15–25 |
| Si&sub3;N&sub4; | Dielectric | 0.6–1.0 | 12–20 |
| Si | Semiconductor | 0.5–0.8 | 10–20 |
| GaAs | III-V semiconductor | 1.0–1.5 | 18–30 |
| LiNbO&sub3; | Piezoelectric | 0.6–0.9 | 10–18 |
Note: Etch rates scale roughly linearly with beam current density. Values above assume ~0.5 mA/cm². Rates increase by 50–100% at peak sputter yield angles (typically 40–60° from normal).
6. The Critical Role of Angle: Tilt and Rotation
Unlike any plasma-based etch technique, IBE provides full control over the ion beam’s angle of incidence. This is arguably the single most important process knob in ion beam etching, and it serves multiple functions:
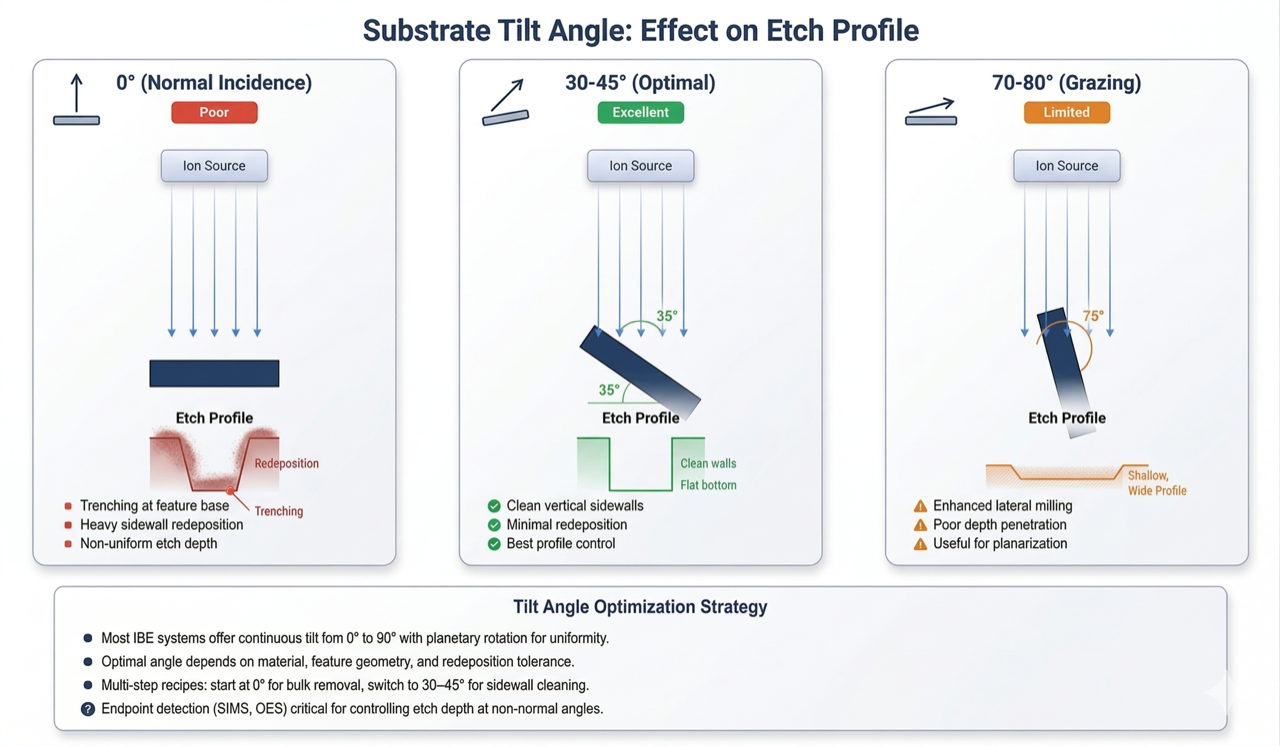
Figure 3: Effect of substrate tilt angle on etch profile — normal incidence (0°) causes trenching and redeposition, optimal angles (30–45°) produce clean sidewalls, and grazing angles (70–80°) enhance surface milling but reduce depth
6.1 Sputter Yield vs Angle
For most materials, the sputter yield peaks at 40–60° from normal incidence (where the ion’s momentum is optimally partitioned between penetration depth and lateral cascade). At normal incidence (0°), ions penetrate deeply but displace fewer surface atoms. At grazing angles (>75°), ions scatter from the surface with minimal energy transfer. This angular dependence is the basis for profile engineering:
- Normal incidence (0°): Maximum vertical etch rate, produces steep sidewalls but leaves redeposited material on feature flanks
- Moderate tilt (30–45°): Accesses sidewalls directly, cleans redeposition, produces tapered profiles useful for step coverage of subsequent depositions
- High tilt (60–80°): Aggressive sidewall cleaning, extreme taper, useful for redeposition removal passes
6.2 Multi-Step Angle Recipes
Production IBE processes often use multi-step angle sequences:
- Bulk etch at 0–10°: Remove the majority of the film thickness at maximum vertical rate
- Profile trim at 30–45°: Shape the sidewall angle and partially remove redeposited fences
- Cleanup at 60–70°: Remove remaining sidewall redeposition ("ears" or "veils") without significantly affecting feature depth
Throughout all steps, continuous substrate rotation (1–10 rpm on NineScrolls systems) ensures azimuthal uniformity — without rotation, shadowing effects from the tilted beam would produce asymmetric profiles.
7. Process Parameters and Optimization
Optimizing an IBE/RIBE process involves balancing etch rate, profile control, selectivity, uniformity, and substrate damage. The key parameters and their effects:
| Parameter | Typical Range | Effect of Increasing | Tradeoff |
|---|---|---|---|
| Beam voltage | 200–1200 V | Higher etch rate, deeper ion penetration | More subsurface damage, faster mask erosion |
| Beam current | 10–200 mA | Higher etch rate (linear scaling) | More substrate heating, potential grid erosion |
| Tilt angle | 0–90° | Better sidewall access, reduced redeposition | Lower vertical etch rate, wider footprint needed |
| Rotation speed | 1–10 rpm | Better azimuthal uniformity | Minimal tradeoff; 3–5 rpm typical |
| Gas flow (Ar) | 5–30 sccm | Higher beam current at given discharge power | Higher chamber pressure, more scattering |
| Reactive gas ratio (RIBE) | 0–80% of total flow | More chemical etch component, higher selectivity | Grid erosion (with halides), less directionality |
| Substrate temperature | 5–20°C (water cooled) | Higher temperature increases chemical etch rates in RIBE | May cause photoresist degradation, diffusion in sensitive layers |
Endpoint Detection
IBE endpoint detection is typically accomplished by Secondary Ion Mass Spectrometry (SIMS) monitoring or optical emission spectroscopy of the sputtered species. Many systems also incorporate a quartz crystal microbalance or reflectometry for real-time etch depth monitoring. For multi-layer stacks (e.g., MTJ pillars with 10+ layers), SIMS endpoint is particularly valuable since each layer transition produces a distinct mass signature.
8. Applications
8.1 Magnetic Devices and MRAM
This is the defining application for IBE. Magnetic tunnel junctions (MTJs) — the core element of MRAM, magnetic sensors, and spin-torque oscillators — consist of multi-layer stacks of CoFeB/MgO/CoFeB sandwiched between antiferromagnetic pinning layers (PtMn, IrMn) and metallic electrodes (Ta, Ru, Pt). No plasma chemistry can produce volatile etch products from these materials, making IBE the only viable patterning technique.
Critical IBE challenges for MTJ fabrication:
- Sidewall redeposition: Sputtered conductive material redepositing on the tunnel barrier sidewall creates electrical shorts. Multi-angle recipes (etch + cleanup) are essential.
- Magnetic dead layers: Excessive ion energy damages the ultrathin (~1 nm) CoFeB free layer, degrading tunnel magnetoresistance (TMR). Low-energy (<400 eV) finishing steps preserve magnetic properties.
- Pillar profile: Sub-50 nm MTJ pillars require steep sidewalls with minimal taper to maintain consistent junction area across the wafer. Tilt angle optimization is critical.
8.2 Photonics and Optical Devices
IBE is widely used for patterning optical thin-film stacks — multilayer dielectric mirrors, waveguide facets, and diffractive optical elements — where surface smoothness and angle precision are paramount. Specific applications include:
- Thin-film filter trimming: Precise thickness adjustment of optical interference filters by controlled ion milling
- LiNbO&sub3; waveguide fabrication: Domain-engineered lithium niobate for electro-optic modulators, where RIE produces unacceptable surface roughness
- Metasurface patterning: Sub-wavelength metallic and dielectric nanostructures for flat optics
- Laser facet polishing: Angled IBE to smooth cleaved or etched facets of semiconductor laser diodes
8.3 MEMS and Sensors
- Piezoelectric MEMS: PZT and AlN transducer patterning for ultrasonic sensors, energy harvesters, and RF filters
- Magnetic sensors: GMR/TMR sensor elements for automotive, industrial, and biomedical applications
- SAW/BAW devices: Surface and bulk acoustic wave resonator electrode definition on quartz and LiTaO&sub3; substrates
8.4 Quantum Devices and 2D Materials
Emerging applications increasingly leverage IBE’s low-damage, material-agnostic etching for:
- Superconducting qubit fabrication: Patterning Nb and Al/AlOx/Al Josephson junctions where plasma damage would degrade coherence times
- 2D material device isolation: Defining boundaries in graphene, MoS&sub2;, and hBN heterostructures without chemical damage to adjacent layers
- Topological insulator patterning: Bi&sub2;Se&sub3; and Bi&sub2;Te&sub3; nanostructures where surface state preservation is critical
9. Managing Redeposition: The Central Challenge of IBE
Redeposition is the primary drawback of physical sputtering and the single biggest process challenge in IBE. When ions eject atoms from the target surface, those atoms travel in roughly cosine distributions and can land on mask sidewalls, feature sidewalls, and chamber surfaces. In the worst case, redeposited material forms conductive “fences” or “veils” along feature edges that cause electrical shorts.
Redeposition Mitigation Strategies
- Multi-angle etching: The most effective technique. Follow the bulk etch with a 45–70° cleanup pass to sputter away sidewall deposits. Stage rotation ensures uniform cleanup around the full feature circumference.
- Use RIBE mode: Adding O&sub2; to the beam when etching metals converts redeposited material to oxides, which are often more easily removed. For some materials, the oxide is volatile enough to self-clean during etching.
- Lower beam energy for cleanup: A 200–300 eV cleanup step at high tilt angle removes redeposition without damaging underlying layers as aggressively as the main etch.
- Hardmask optimization: Thicker, more sputter-resistant masks (SiO&sub2;, diamond-like carbon, Ta) survive multi-step recipes and shadow less of the feature base.
- Chamber design: Cooled chamber liners and strategically placed shields intercept redeposited material, preventing it from reflecting back onto the substrate. Regular chamber cleaning maintains process consistency.
10. NineScrolls IBE/RIBE System Specifications
The NineScrolls IBE/RIBE platform is designed for research flexibility and production-grade process control. Key specifications:
| Specification | Detail |
|---|---|
| Ion source options | Kaufman-type (up to 6″ wafers) or RF ion source (up to 12″ wafers) |
| Wafer stage | Tilt 0–90°, rotation 1–10 rpm programmable |
| Substrate cooling | Water cooling 5–20°C; optional backside He cooling for sensitive devices |
| Base pressure | <7×10−&sup7; Torr |
| Process gas | Standard 1–3 lines (Ar, O&sub2;, CHF&sub3;, etc.); customizable |
| Film non-uniformity | <5% |
| Loading | Open-load or load-lock configuration |
| Footprint | 1.0 m × 0.8 m |
| Compatible materials | Magnetic (NiFe, CoFe), optical (glass, quartz), semiconductors (Si, GaAs, InP), metals (Au, Pt, Cu), dielectrics (SiO&sub2;, Si&sub3;N&sub4;), 2D/quantum materials |
The compact footprint (1.0 m × 0.8 m) makes the NineScrolls IBE/RIBE system suitable for both university cleanrooms and production fabs, while the load-lock option minimizes pump-down time and prevents atmospheric contamination of sensitive magnetic and optical films.
11. Troubleshooting Guide
| Problem | Likely Cause | Solution |
|---|---|---|
| Conductive fences/veils on feature sidewalls | Redeposition from sputtered target material | Add 45–70° cleanup step with rotation; consider RIBE with O&sub2; assist |
| Non-uniform etch across wafer | Beam profile drift, grid erosion, or insufficient rotation | Check/replace extraction grids; verify rotation motor; perform beam profile measurement with Faraday probe |
| Etch rate declining over time | Filament degradation (Kaufman), grid hole widening, chamber coating buildup | Replace filament or grids; clean chamber liners; track beam current as process monitor |
| Photoresist burning or hardening | Excessive substrate heating from high beam power | Reduce beam voltage/current; enable backside He cooling; use intermittent etching (etch → cool → etch) |
| Degraded magnetic properties (low TMR) | Ion implantation damage to thin magnetic layers | Reduce beam voltage to <400 eV for final 5–10 nm; use endpoint detection to stop precisely at the tunnel barrier |
| Asymmetric feature profiles | Stage rotation failure or misaligned beam | Verify rotation mechanism; check ion source alignment; run test etch on blanket film to map beam profile |
| Arcing or beam instability | Conductive coating on grids or insulators; gas leak | Clean or replace grids; inspect ceramic insulators for metal coating; leak-check gas lines and chamber seals |
| Poor selectivity to mask | Mask material sputter yield too close to target material | Switch to a harder mask (SiO&sub2;, Cr, Ta, or diamond-like carbon); use RIBE mode for chemistry-assisted selectivity |
12. Frequently Asked Questions
What is the difference between IBE and RIBE, and when should I use each?
IBE (Ion Beam Etching) uses a pure inert-gas ion beam (typically Ar+) for physical sputtering only. RIBE (Reactive Ion Beam Etching) introduces reactive gases into the ion source to produce chemically active ions that both sputter and react with the substrate. Use IBE when etching materials with non-volatile etch products (magnetic alloys, noble metals, complex oxides) where no reactive chemistry can help. Use RIBE when etching semiconductors or dielectrics where adding chemical reactivity improves selectivity and reduces redeposition — for example, using O&sub2;-assisted RIBE to etch through a multi-layer stack and stop cleanly on an oxide layer.
Can IBE/RIBE replace ICP-RIE for semiconductor etching?
Not as a general replacement. ICP-RIE achieves much higher etch rates (10–50×) for silicon and dielectrics, better selectivity through chemistry tuning, and higher throughput. IBE/RIBE complements ICP-RIE by handling the materials that plasma chemistry cannot etch — noble metals, magnetic alloys, and multi-element oxides. Many advanced device fabs operate both ICP-RIE and IBE systems: ICP-RIE for the bulk semiconductor and dielectric layers, and IBE for the metal and magnetic stack layers. For a detailed comparison of ICP-RIE capabilities, see our ICP-RIE Technology Guide.
How do I minimize ion damage to sensitive thin films like MTJ tunnel barriers?
Three main strategies: (1) Reduce beam voltage to 200–400 eV for the final etching step near the sensitive layer — this dramatically reduces the ion penetration depth and lattice displacement. (2) Use precise endpoint detection (SIMS or reflectometry) to stop the etch at exactly the right layer interface. (3) Consider a gentle post-etch treatment at very low energy (<100 eV) and high tilt angle to remove damaged surface atoms without penetrating deeper. On NineScrolls systems, the programmable beam voltage allows multi-step recipes that transition automatically from high-energy bulk etching to low-energy finishing.
Should I choose a Kaufman source or an RF ion source?
For R&D labs processing wafers up to 6″ with primarily Ar-based IBE, a Kaufman source offers excellent performance at lower cost. For production environments, larger wafers (up to 12″), or processes requiring reactive gases (RIBE mode with O&sub2;, CHF&sub3;, Cl&sub2;), the RF ion source is the better choice. The RF source eliminates filament replacement, handles reactive gases without degradation, and scales to larger beam diameters. NineScrolls offers both options on the same platform, so the source can be upgraded if your process requirements evolve.
What maintenance does an IBE system require?
Routine maintenance includes: (1) Filament replacement (Kaufman source only) every 50–200 hours of operation depending on gas type and beam current. (2) Grid inspection and cleaning every 100–500 hours — check for hole erosion, sputtered coating buildup, and alignment. Grids should be replaced when hole diameters increase by >20% from nominal. (3) Chamber liner cleaning periodically to remove redeposited material that can flake and cause particles. (4) Neutralizer filament replacement at intervals similar to the source filament. (5) Vacuum system maintenance — turbo pump bearing checks, gate valve seal inspection, and leak testing per standard UHV practice.
13. Conclusion: Where IBE/RIBE Fits in Your Process Flow
Ion beam etching occupies a unique and increasingly important niche in microfabrication. While RIE and ICP-RIE handle the bulk of semiconductor and MEMS etching through chemistry-driven processes, IBE/RIBE is indispensable whenever the target material resists chemical volatilization, whenever precise angle control is needed, or whenever plasma-induced charge damage is unacceptable.
The growing importance of spintronics (MRAM, magnetic sensors), integrated photonics (LiNbO&sub3; modulators, metasurfaces), and quantum devices (superconducting qubits, topological materials) means that demand for high-quality ion beam etching continues to expand. A well-configured IBE/RIBE system — with both Kaufman and RF source options, full tilt/rotation capability, and precise endpoint detection — is a versatile addition to any cleanroom that works beyond conventional CMOS materials.
NineScrolls IBE/RIBE System Series
Our IBE/RIBE platform delivers precise, material-agnostic etching with Kaufman-type or RF ion sources, full 0–90° tilt with programmable rotation, base pressure <7×10−&sup7; Torr, and <5% film non-uniformity. From magnetic tunnel junction patterning to photonic device fabrication, the NineScrolls IBE/RIBE series handles the materials that plasma etchers cannot — in a compact 1.0 m × 0.8 m footprint with open-load or load-lock configurations.