Plasma Stripping & Ashing Equipment: Selection Guide for Research Labs
By NineScrolls Engineering · 2026-03-07 · 12 min read · Materials Science
Target Readers: Process engineers, lab managers, PIs, and procurement teams evaluating plasma stripping and ashing equipment for university cleanrooms, national labs, or R&D fabs. Whether you are replacing an aging barrel asher or specifying a new tool for advanced photoresist and residue removal, this guide will help you navigate the key tradeoffs.
TL;DR Summary
Plasma stripping (ashing) removes photoresist and organic residues using reactive plasma — but the equipment architecture you choose determines strip rate, uniformity, substrate damage, and cost. Barrel ashers offer high throughput at low cost but lack uniformity control. Downstream (remote) strippers minimize ion damage by separating the plasma source from the wafer, making them the workhorse for most R&D labs. RIE-mode strippers add ion bombardment for stubborn post-etch residues but risk substrate damage. This guide compares these architectures, walks through gas chemistry selection, explains temperature effects on strip rate, covers endpoint detection methods, and provides a decision framework for choosing between a striper and a plasma cleaner.
1) Why Equipment Selection Matters
Photoresist stripping is one of the most frequently performed processes in any micro/nanofabrication lab. A poorly chosen tool leads to incomplete strip, post-strip residues, substrate damage, or excessive process time — all of which cascade into downstream yield loss. The right equipment selection depends on your resist types (positive, negative, image-reversal, e-beam, thick/thin), substrate materials (Si, III-V, oxides, metals, 2D materials), throughput needs, and damage tolerance.
For a deep dive into the underlying plasma chemistry and process types, see our companion article: Plasma Stripping & Ashing — Principles, Gas Chemistry, and Equipment Guide.
2) Equipment Architectures Compared
There are three primary plasma stripping architectures, each with distinct advantages. Understanding their operating principles is the first step toward selecting the right tool.
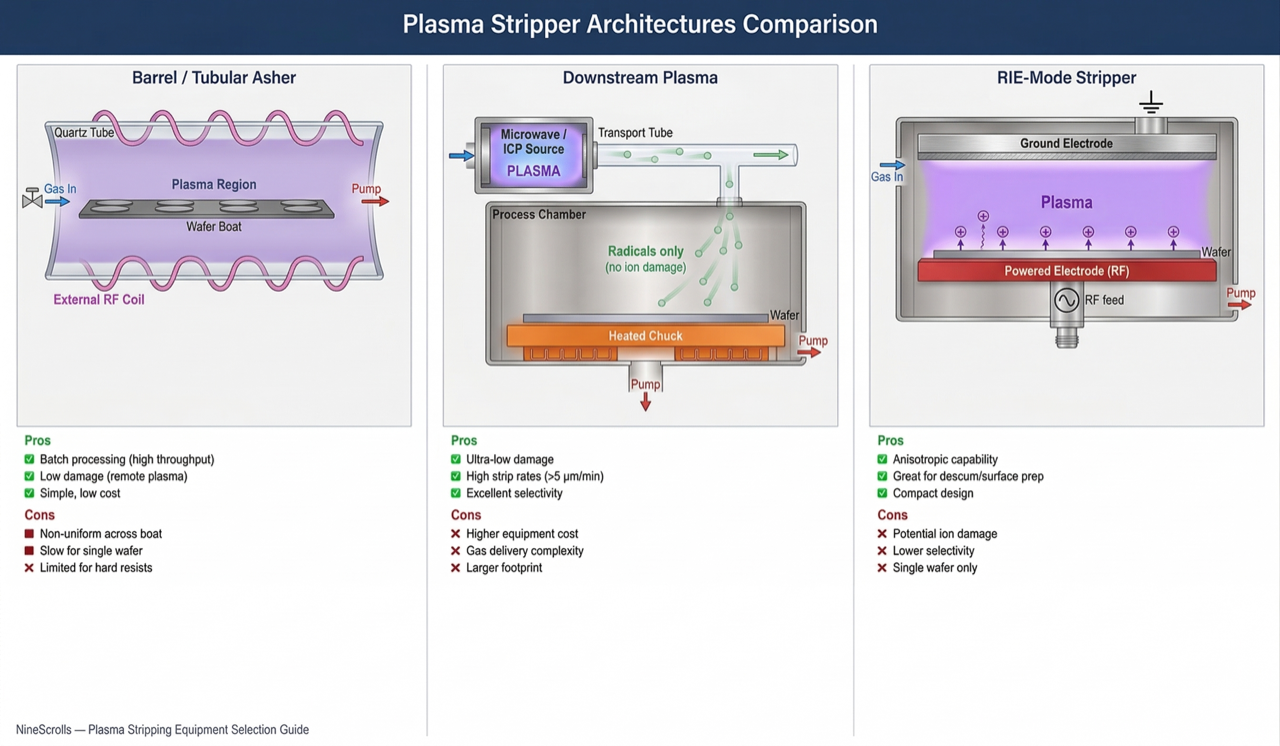
Figure 1: Three stripper architectures compared — barrel/tubular ashers for batch processing, downstream plasma for damage-sensitive applications, and RIE-mode strippers for directional descum and surface preparation
2.1 Barrel (Tubular) Ashers
The barrel asher is the simplest and oldest plasma stripping architecture. A quartz or alumina tube is placed inside an RF coil (typically operating at 13.56 MHz or 2.45 GHz microwave). Wafers are loaded on a boat or rack inside the tube, and the plasma fills the entire tube volume.
- Pros: High batch throughput (10–25 wafers), low cost, simple operation, minimal maintenance
- Cons: Poor wafer-to-wafer and within-wafer uniformity, direct plasma exposure (ion damage), limited temperature control, no endpoint detection
- Best for: Bulk PR removal where substrate damage tolerance is high (e.g., thick resist strip after deep Si etch, non-critical cleaning steps)
2.2 Downstream (Remote Plasma) Strippers
In a downstream stripper, the plasma is generated in a separate chamber (the source region) and reactive radicals are transported through a tube or baffle to the wafer stage. Ions recombine on the transport walls before reaching the substrate, so the wafer sees only neutral radicals — primarily atomic oxygen (O*) in an O₂ plasma.
- Pros: Minimal ion damage, excellent for damage-sensitive substrates (III-V, 2D materials, gate oxides), good uniformity with proper gas distribution, temperature-controlled stage enables rate tuning
- Cons: Lower strip rate than RIE-mode (no ion enhancement), may struggle with heavily cross-linked or ion-implanted resist (hard-baked crust)
- Best for: Most R&D lab applications — standard PR strip, descum, post-etch residue removal, surface activation
The NineScrolls Striper uses a center pump-down design with an adjustable discharge gap, providing the benefits of downstream radical delivery while maintaining high strip rates through optimized gas residence time.
2.3 RIE-Mode Strippers
RIE-mode strippers place the wafer on the powered electrode of a parallel-plate or ICP reactor. The wafer experiences both radical chemistry and energetic ion bombardment, which physically sputters and chemically volatilizes stubborn residues.
- Pros: Highest strip rate, can remove hard-baked/cross-linked resist and post-etch polymer, enables anisotropic residue removal
- Cons: Ion damage to substrate and underlying films, potential sputtering of underlying metal (causes redeposition), gate oxide degradation, requires careful endpoint to avoid over-etch
- Best for: Post-etch residue removal in metal/via etch, hardened resist removal, applications where damage budget is generous
Architecture Comparison Table
| Parameter | Barrel Asher | Downstream Stripper | RIE-Mode Stripper |
|---|---|---|---|
| Plasma Exposure | Direct (ions + radicals) | Radicals only | Direct (ions + radicals) |
| Ion Damage | Moderate–High | Minimal | Moderate–High |
| Strip Rate (1 µm PR) | 1–3 µm/min | 0.5–2 µm/min | 2–5 µm/min |
| Uniformity | ±10–20% | <5% | <5% |
| Batch Capability | 10–25 wafers | 1 wafer (or multi-wafer) | 1 wafer |
| Endpoint Detection | Rarely available | OES / interferometry | OES / interferometry |
| Temperature Control | Limited (oven-style) | Water-cooled stage, 5–200 °C | Heated/cooled chuck |
| Typical Cost | $ | $$ | $$$ |
| Best Use Case | Bulk PR removal, teaching labs | General R&D, damage-sensitive substrates | Post-etch polymer, hardened resist |
3) Gas Chemistry Selection
The choice of process gas determines the stripping mechanism, rate, selectivity, and residue behavior. Most stripping processes start with O₂, but additives unlock critical capabilities for specific applications.

Figure 2: Gas chemistry selection matrix — color-coded ratings for five common stripping chemistries across strip rate, selectivity, residue removal, and metal compatibility metrics
3.1 Pure O₂
Pure oxygen plasma is the default chemistry for photoresist ashing. Atomic oxygen radicals (O*) react with the organic resist to form volatile CO₂ and H₂O. This is the simplest, cleanest, and most widely used stripping chemistry.
- Strip rate: 0.5–3 µm/min depending on power, temperature, and architecture
- Selectivity: Excellent to Si, SiO₂, Si₃N₄ (no etching of inorganic materials)
- Limitations: Oxidizes exposed metals (Cu, Al, Ti), cannot remove inorganic residues, slow on ion-implanted (hardened) resist crust
- Typical use: Standard positive/negative PR strip, descum, surface activation
3.2 O₂/CF₄ (Fluorine-Assisted Stripping)
Adding 5–20% CF₄ to the O₂ plasma introduces fluorine radicals that break through inorganic resist crust (formed by ion implantation or hard-bake) and attack silicon-containing residues. The fluorine radicals break Si–O and Si–C bonds in the hardened surface layer, exposing the underlying organic resist to O radical attack.
- Strip rate: 1.5–5 µm/min (30–100% faster than pure O₂ on hardened resist)
- Selectivity: Reduced selectivity to SiO₂ and Si₃N₄ — monitor CF₄ concentration carefully
- Limitations: Can etch underlying dielectrics if over-exposed, CF₄ is a potent greenhouse gas (use only when needed)
- Typical use: Post-implant resist strip, removal of resist with inorganic fillers, post-RIE polymer residue removal
Process tip: Start with 5% CF₄ and increase in 5% increments. Monitor the underlying oxide thickness with ellipsometry after each run to establish the safe process window.
3.3 H₂/N₂ (Reducing Chemistry)
A hydrogen-nitrogen plasma (typically 4:1 H₂:N₂ or forming gas composition) strips resist through a reducing mechanism — hydrogen radicals abstract carbon from the polymer backbone, forming volatile CH₄ and other hydrocarbons. This avoids any oxidation of the substrate.
- Strip rate: 0.3–1.5 µm/min (slower than O₂, but damage-free)
- Selectivity: Excellent — no oxidation of Cu, low-k dielectrics, or sensitive metal stacks
- Limitations: Lower strip rate, potential H₂ safety requirements (gas cabinet, leak detection), post-strip surface may be hydrogen-terminated (not always desirable)
- Typical use: Cu/low-k dual damascene, III-V compound semiconductor processing, any stack with exposed oxidation-sensitive metals
3.4 Forming Gas (N₂/H₂ 96:4)
Forming gas (96% N₂, 4% H₂) is a non-flammable alternative to pure H₂/N₂ mixtures that still provides a mildly reducing environment. The lower hydrogen concentration results in slower strip rates but eliminates the need for hydrogen safety infrastructure.
- Strip rate: 0.1–0.5 µm/min
- Selectivity: Very high — minimal interaction with any substrate material
- Typical use: Gentle surface cleaning, organic contamination removal, labs without H₂ gas infrastructure
Gas Chemistry Decision Matrix
| Application | Recommended Gas | Why |
|---|---|---|
| Standard PR strip | Pure O₂ | Fastest, cleanest, no substrate interaction |
| Post-implant resist | O₂ + 5–15% CF₄ | Breaks through implant-hardened crust |
| Cu/low-k backend | H₂/N₂ (4:1) | Non-oxidizing — preserves Cu and low-k integrity |
| III-V surface prep | H₂/N₂ or forming gas | Prevents native oxide growth on GaAs, InP |
| Post-etch polymer | O₂ + 10% CF₄ | Attacks both organic and inorganic residue components |
| Descum / activation | Pure O₂ (low power) | Gentle removal of thin organic film or scum |
| 2D materials (MoS₂, graphene) | Forming gas or remote O₂ | Minimizes damage to atomically thin layers |
4) Temperature Effects on Strip Rate
Substrate temperature is one of the most powerful levers for controlling strip rate, and it is often underappreciated. The stripping reaction follows Arrhenius kinetics — strip rate increases exponentially with temperature.
4.1 Temperature–Rate Relationship
For O₂ plasma stripping of standard positive photoresist:
- 25 °C: ~0.3–0.8 µm/min (room temperature baseline)
- 100 °C: ~1.0–2.5 µm/min (3–4× faster)
- 150 °C: ~2.0–4.0 µm/min (6–8× faster)
- 200 °C: ~3.0–5.0 µm/min (10× faster, but risk of resist reflow/popping)
The activation energy for O₂ radical stripping of novolac-based resists is approximately 0.3–0.5 eV, giving a rate doubling every ~30–40 °C.
4.2 When to Use Elevated Temperature
- Thick resist (>5 µm): Run at 120–150 °C to reduce process time from 15+ minutes to under 5 minutes
- High throughput requirements: Labs processing many wafers/day benefit from faster strip cycles
- Hardened resist: Temperature softens the cross-linked crust, improving radical penetration
4.3 When to Stay Cool
- Damage-sensitive substrates: Gate oxides, III-V surfaces, 2D materials — stay at 25–60 °C to minimize thermal stress and diffusion
- Metal stacks with thermal budget: Cu hillocking starts above ~150 °C; Al can develop stress voids
- Thick resist with solvent residue: Rapid heating can cause resist "popping" — trapped solvents explosively degas, leaving particulate contamination. Ramp gradually or use a two-step process (low-temp pre-bake, then high-temp strip).
The NineScrolls Striper provides a water-cooled stage with a 5–200 °C range, allowing precise temperature control across this full operating window.
5) Endpoint Detection Methods
Accurate endpoint detection prevents both under-strip (residue left behind) and over-strip (unnecessary plasma exposure that can damage underlying films). Two primary methods are used in modern stripping equipment.
5.1 Optical Emission Spectroscopy (OES)
OES monitors the light emitted by excited species in the plasma. During resist stripping, CO* (carbon monoxide radical) emission lines at 283 nm, 297 nm, and 519 nm indicate active organic combustion. When the resist is fully removed, CO* emission drops sharply — this is the endpoint signal.
- Advantages: Non-contact, real-time, no consumables, works for any organic material
- Limitations: Requires a viewport or fiber-optic port to the plasma region; signal may be weak for very thin films (<100 nm)
- Implementation: A spectrometer monitors the CO* emission wavelength. Software tracks intensity vs. time and triggers endpoint when the signal drops below a threshold (typically 10–20% of peak intensity)
5.2 Laser Interferometry
A laser beam (typically 670 nm HeNe) reflects off the wafer surface during stripping. As the transparent resist film thins, constructive and destructive interference produces oscillations in reflected intensity. When the resist is fully removed, the oscillations stop and the signal stabilizes at the bare-substrate reflectivity.
- Advantages: Directly measures film thickness in real time, works for very thin films, quantitative (each oscillation = λ/2n thickness change)
- Limitations: Requires optical access to the wafer surface, sensitive to wafer alignment, does not work on opaque substrates without modification
5.3 Choosing an Endpoint Method
| Criterion | OES | Laser Interferometry |
|---|---|---|
| Thin film detection (<100 nm) | Fair | Excellent |
| Thick film (>1 µm) | Excellent | Good (many oscillations) |
| Multiple materials | Good (track different species) | Limited (one reflection point) |
| Setup complexity | Low | Moderate |
| Cost | $–$$ | $$–$$$ |
The NineScrolls Striper includes automated, real-time endpoint detection as standard — eliminating the guesswork of timed-etch recipes.
6) Batch vs. Single-Wafer Tradeoffs
This decision depends on your lab's volume, process control requirements, and the diversity of processes you run.
6.1 Single-Wafer Processing
- Uniformity: <5% within-wafer uniformity is routine — critical for research where every wafer matters
- Process control: Endpoint detection, real-time temperature monitoring, and recipe flexibility per wafer
- Flexibility: Easily switch between different gas chemistries, temperatures, and power levels between wafers
- Throughput: Lower than batch — typically 6–15 wafers/hour depending on strip time
6.2 Batch (Multi-Wafer) Processing
- Throughput: 20–50 wafers/hour for standard strip processes
- Cost per wafer: Significantly lower for high-volume operations
- Uniformity: Wafer-to-wafer variation can be ±10–20% in barrel systems, ±5–8% in optimized multi-wafer downstream systems
- Limitations: All wafers in the batch receive the same process — no per-wafer optimization
6.3 The R&D Lab Sweet Spot
Most university and R&D labs benefit from a single-wafer downstream stripper with multi-wafer capability as an option. This provides the process control needed for research work while allowing batch processing for teaching labs or production-like runs. The NineScrolls Striper supports configurations from 4" to 12" single wafers or multi-wafer processing, covering the full range of R&D lab needs.
7) Striper vs. Plasma Cleaner: When to Use Which
Both stripers and plasma cleaners generate reactive plasma species to modify surfaces, but they are optimized for different applications. Understanding the boundary helps you avoid misusing equipment or purchasing redundant tools.
| Criterion | Plasma Striper | Plasma Cleaner |
|---|---|---|
| Primary function | Remove thick organic films (1–50 µm PR) | Remove thin organic contamination (<100 nm), activate surfaces |
| RF power range | 300–1000 W | 50–300 W |
| Temperature control | Active (water-cooled, 5–200 °C) | Passive or minimal |
| Endpoint detection | Yes (OES / interferometry) | Rarely |
| Gas lines | 2+ (O₂, CF₄, H₂/N₂) | 1–2 (O₂, Ar) |
| Process time | 1–15 min (depending on thickness) | 30 s – 5 min |
| Use cases | PR strip, post-etch polymer, descum, thick film removal | Surface activation, contact angle improvement, pre-bonding, organic contamination removal |
Rule of thumb: If you are removing a film that was intentionally deposited (photoresist, polymer layer), use a striper. If you are removing adventitious contamination or activating a surface, use a plasma cleaner.
For more on plasma cleaner applications and maintenance, see our Plasma Cleaner Maintenance Guide.
8) Damage-Sensitive Stripping for Advanced Devices
As device dimensions shrink and new materials enter the fab (high-k gate oxides, Cu/low-k interconnects, 2D materials, III-V channels), the tolerance for plasma-induced damage during resist strip decreases dramatically. Here are strategies for minimizing damage while maintaining adequate strip performance.
8.1 Strategies for Low-Damage Stripping
- Use downstream/remote plasma: Ion-free radical chemistry is the single most effective damage-reduction strategy. The NineScrolls Striper's center pump-down design with adjustable discharge gap provides this capability.
- Reduce RF power: Lower power reduces both radical flux and residual ion energy. Accept slower strip rates in exchange for damage reduction.
- Lower pressure (1–5 Torr): Reduces ion density and energy in downstream systems
- Use H₂/N₂ chemistry: Eliminates oxidation damage entirely — essential for Cu and low-k
- Optimize temperature: Use moderate temperature (80–120 °C) to boost chemical strip rate without excessive thermal budget
- Two-step stripping: First step at low power/temperature to remove bulk resist, second step at higher power to clean residual film — limits total damage exposure
8.2 Specific Material Considerations
| Substrate / Material | Key Concern | Recommended Approach |
|---|---|---|
| Gate oxide (<5 nm) | Charge damage, oxide degradation | Downstream O₂, low power (<300 W), <60 °C |
| Cu interconnects | Oxidation → increased resistance | H₂/N₂ chemistry, <150 °C |
| Low-k dielectrics (k < 2.5) | Carbon depletion → k increase | H₂/N₂ or forming gas, minimal O₂ exposure |
| III-V (GaAs, InP, GaN) | Preferential element desorption, native oxide | Downstream H₂/N₂, <100 °C, immediate passivation |
| 2D materials (graphene, MoS₂) | Structural damage, defect introduction | Remote plasma, forming gas, ultra-low power, room temp |
| MEMS released structures | Stiction, structural damage from ion bombardment | Downstream O₂, moderate temp, vapor HF alternative for sacrificial oxide |
9) Equipment Specification Checklist
When evaluating stripping equipment for your lab, use this checklist to ensure the tool meets your current and anticipated needs.
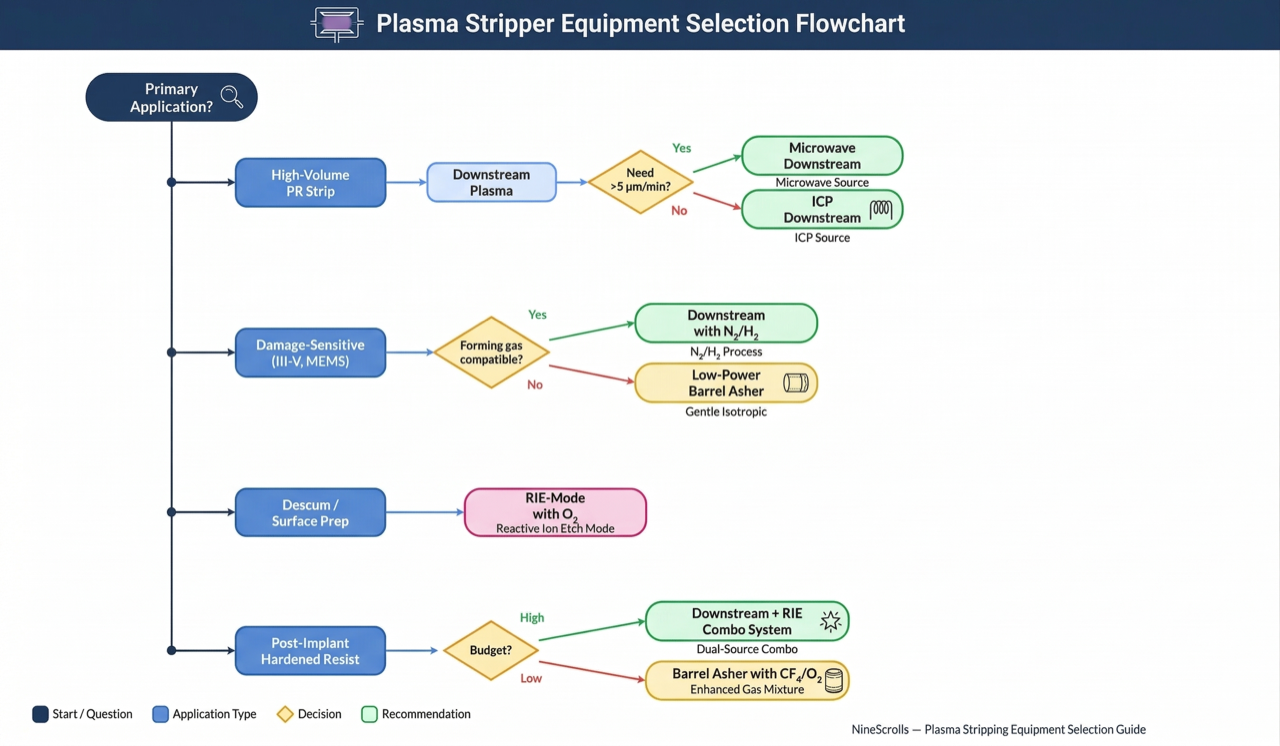
Figure 3: Equipment selection decision flowchart — systematic path from application requirements to recommended stripper architecture and configuration
9.1 Must-Have Specifications
- Wafer size compatibility: Match to your current substrates (4", 6", 8") with upgrade path if needed. The NineScrolls Striper covers 4"–12".
- RF power range: 300–1000 W covers most applications. Higher power = faster strip rates but more potential damage.
- Temperature-controlled stage: Water-cooled with range of at least 20–200 °C. Essential for rate control and damage management.
- Gas system: Minimum 2 gas lines with MFCs. O₂ is mandatory; second line for CF₄ or N₂/H₂ depending on your applications.
- Uniformity specification: <5% 1σ across the wafer. Insist on measured data, not just catalog claims.
- Endpoint detection: OES at minimum. Automated endpoint eliminates over-processing and improves reproducibility.
9.2 Desirable Features
- Adjustable discharge gap: Allows optimization of radical residence time and uniformity (available on the NineScrolls Striper)
- Center pump-down: Provides symmetric gas flow for better uniformity
- Recipe storage and automation: Multi-step recipes with automatic gas/power/temperature transitions
- Small footprint: Lab space is always at a premium. The NineScrolls Striper's 0.8 × 0.8 m footprint is among the smallest in its class.
- Process logging: Time-stamped records of power, pressure, temperature, and endpoint for troubleshooting and publications
NineScrolls Striper Specifications
| Parameter | Specification |
|---|---|
| Wafer Size | 4"–12" (single) or multi-wafer |
| RF Power | 300–1000 W, customizable |
| Stage Temperature | 5–200 °C, water-cooled |
| Gas System | 2 lines standard (expandable) |
| Uniformity | <5% (1σ) |
| Footprint | 0.8 m × 0.8 m |
| Endpoint Detection | Automated, real-time (OES) |
| Chamber Design | Center pump-down, adjustable discharge gap |
10) Frequently Asked Questions
What strip rate can I expect for standard positive photoresist?
For a downstream O₂ plasma at 500 W and 120 °C stage temperature, expect 1.5–2.5 µm/min for standard novolac-based positive resists (e.g., AZ 1500 series, Shipley 1800 series). Thicker or chemically amplified resists may strip faster due to lower cross-link density. Post-implant hardened resist may require O₂/CF₄ chemistry and will strip at 1–2 µm/min initially until the crust is penetrated.
Can I use a plasma stripper for SU-8 removal?
SU-8 is an epoxy-based negative resist that becomes heavily cross-linked after UV exposure and hard-bake. Plasma stripping of fully cross-linked SU-8 is very slow (0.05–0.2 µm/min in O₂ plasma) and not recommended as the primary removal method. For partial SU-8 removal, O₂/CF₄ chemistry at high power (800–1000 W) and elevated temperature (180–200 °C) can work, but expect long process times. For thick SU-8 (>50 µm), consider a wet strip with SU-8 remover (e.g., Remover PG at 80 °C) followed by a plasma descum to clear residual organics.
How do I know if I need a striper or a plasma cleaner?
If you are removing a deposited film (photoresist, polymer coating, organic sacrificial layer), you need a striper — it has the power, temperature control, gas flexibility, and endpoint detection to handle thick-film removal efficiently. If you are removing surface contamination, improving wettability/adhesion, or preparing surfaces for bonding, a plasma cleaner is sufficient and simpler to operate. Many labs have both: a striper in the lithography bay and a plasma cleaner near the bonding or metallization tools. See our plasma cleaner and striper product pages for specifications.
What is the advantage of center pump-down design?
Center pump-down (pumping from the center of the chamber rather than one side) creates a radially symmetric gas flow pattern. Gas enters from the periphery, flows radially inward across the wafer surface, and exits through the center. This produces uniform radical flux and uniform strip rate across the wafer — particularly important for wafers larger than 6". Side-pumped chambers can exhibit 10–15% strip rate variation from the pump port side to the opposite side, which center pump-down eliminates.
How often should I clean the stripping chamber?
Chamber cleaning frequency depends on usage intensity and resist type. For typical R&D lab usage (5–20 wafers/day), a weekly O₂ plasma chamber clean (run the standard strip recipe with no wafer for 10–15 minutes) keeps deposition on the walls manageable. Full wet cleaning (open the chamber, wipe with IPA, replace consumables) should be done monthly or when you notice discoloration on the chamber walls, particle counts increasing, or baseline strip rate drifting more than 10%. Always run a conditioning wafer after wet cleaning to re-establish steady-state chamber wall conditions.
Can plasma stripping damage my metal hard mask?
In a downstream O₂ plasma (radical-only), most metals are safe: Cr, Ni, Ti, Au, and Pt show negligible attack. Al and Cu will form surface oxides in O₂ plasma — if this is problematic, switch to H₂/N₂ chemistry. In an RIE-mode stripper, metal sputtering can occur from energetic ion bombardment, leading to redeposition of metal particles on the wafer surface. If you have a metal hard mask, downstream stripping is strongly preferred to avoid sputtering artifacts.
NineScrolls Striper — Plasma Stripping & Ashing Equipment
The NineScrolls Striper delivers <5% uniformity, 300–1000 W customizable RF power, water-cooled stage (5–200 °C), automated real-time endpoint detection, and a compact 0.8 × 0.8 m footprint. Center pump-down design with adjustable discharge gap — from standard PR strip to damage-sensitive advanced node processing.